Инспекцията на полупроводници е критична стъпка за осигуряване на добив и надеждност в целия производствен процес на интегрални схеми. Като детектори за ядра, научните камери играят решаваща роля - тяхната разделителна способност, чувствителност, скорост и надеждност влияят пряко върху откриването на дефекти в микро- и наномащаб, както и върху стабилността на системите за инспекция. За да отговорим на разнообразните нужди на приложенията, ние предлагаме цялостно портфолио от камери, от широкоформатно високоскоростно сканиране до усъвършенствани TDI решения, широко използвани в инспекцията на дефекти на пластини, фотолуминесцентното тестване, метрологията на пластини и контрола на качеството на опаковките.
-

Джемини 8KTDI TDI-sCMOS камера с подсветка
Спектрален диапазон: 180–1100 nm
Типична QE: 63,9% при 266 nm
Максимална скорост на линията: 1 MHz @ 8/10 бита
TDI етап: 256
Интерфейс за данни: 100G / 40G CoF
Метод на охлаждане: Въздух / ТечностВижте още -

Дхяна 9KTDI Pro TDI-sCMOS камера с подсветка
Спектрален диапазон: 180–1100 nm
Типично QE: 50% при 266 nm
Максимална линейна скорост: 600 kHz @ 8/10 бита
TDI етап: 256
Интерфейс за данни: QSFP+
Метод на охлаждане: Въздух / ТечностВижте още -

Дхяна 9KTDI TDI-sCMOS камера с подсветка
Спектрален диапазон: 180–1100 nm
Типично QE: 38% при 266 nm
Максимална линейна скорост: 510 kHz @ 8 бита
TDI етап: 256
Интерфейс за данни: CoaXPress 2.0
Метод на охлаждане: Въздух / ТечностВижте още
-
Може ли EMCCD да бъде заменен и бихме ли искали някога това?
 5234
5234  22.05.2024 г.
22.05.2024 г. -
Предизвикателство пред сканирането на площ? Как TDI може да увеличи 10 пъти заснемането на изображения
 5407
5407  2023-10-10
2023-10-10 -
Ускоряване на заснемането в условия на ограничена светлина с линейно сканиране TDI изображения
 6815
6815  13.07.2022 г.
13.07.2022 г.
-
Проследяване на светлинни маяци в силно мътна вода и приложение за подводно докиране
 1000
1000  31.08.2022 г.
31.08.2022 г. -
Невритен растеж на тригеминални ганглийни неврони in vitro с облъчване с близка инфрачервена светлина
 1000
1000  24.08.2022 г.
24.08.2022 г. -
Високотемпературно устойчиви гъби и оомицети в Корея, включително Saksenaea longicolla sp. nov.
 1000
1000  2022-08-19
2022-08-19

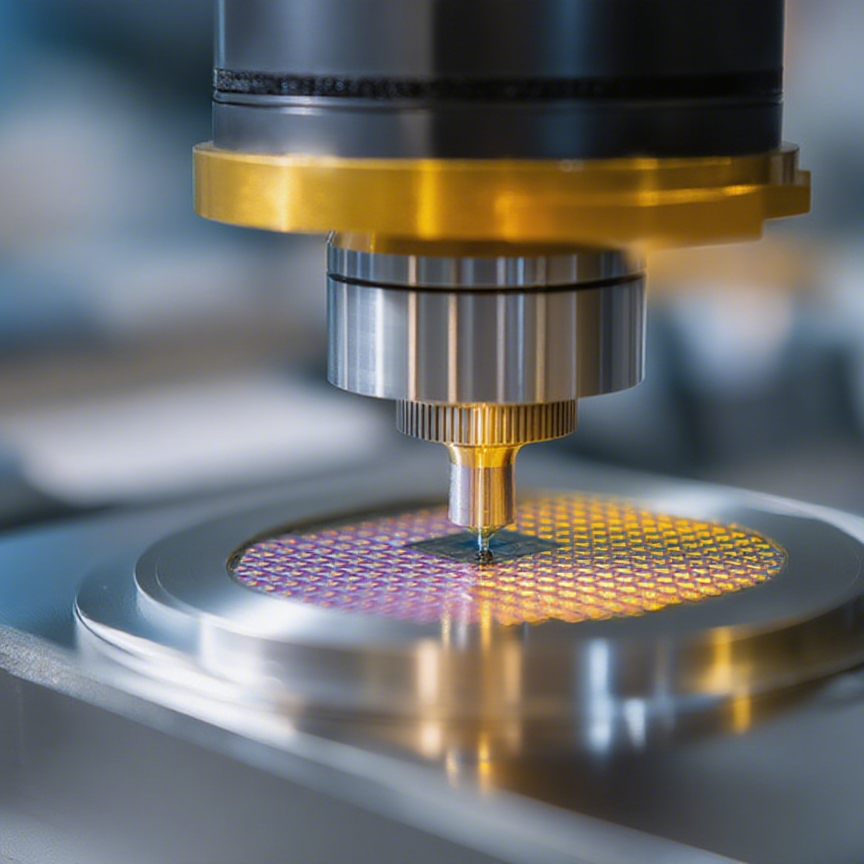

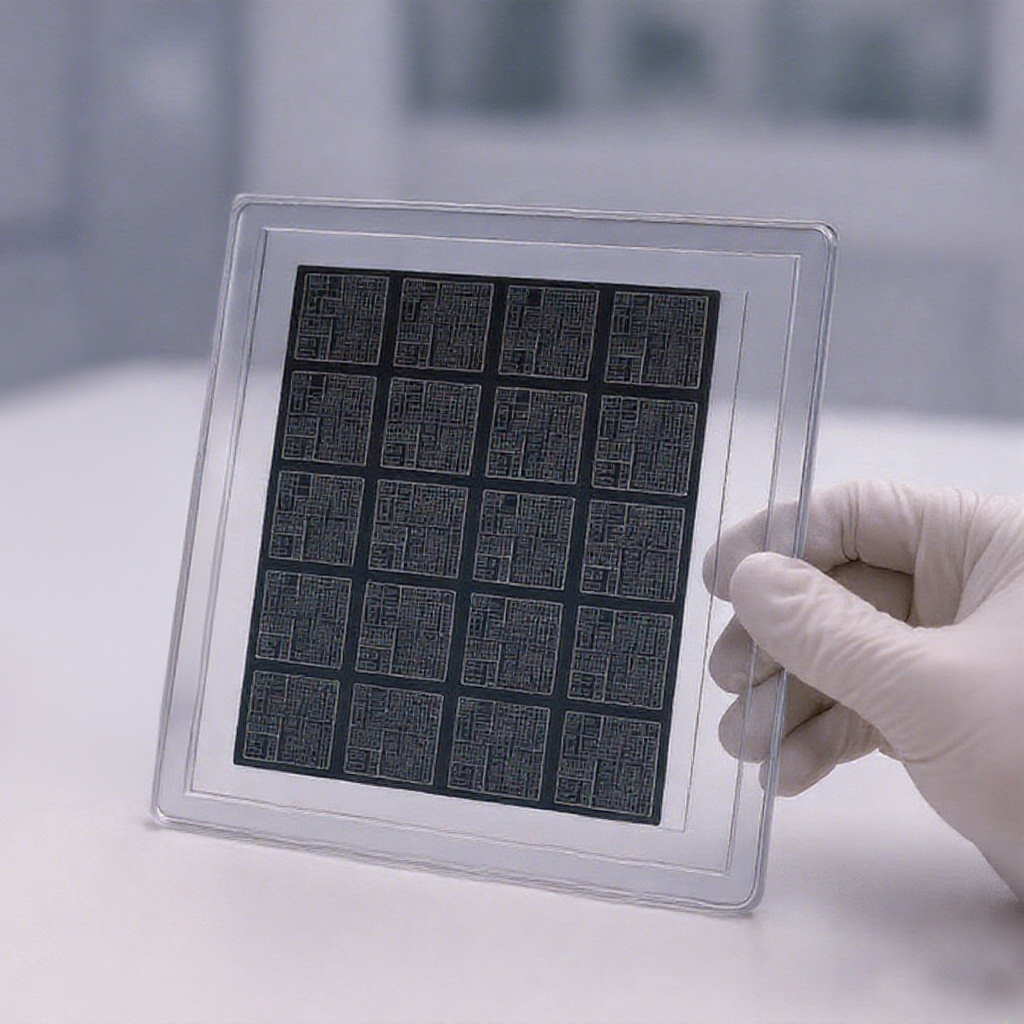

 5234
5234