ការត្រួតពិនិត្យសារធាតុ semiconductor គឺជាជំហានដ៏សំខាន់មួយក្នុងការធានានូវទិន្នផល និងភាពជឿជាក់នៅទូទាំងដំណើរការផលិតសៀគ្វីរួមបញ្ចូលគ្នា។ ក្នុងនាមជាឧបករណ៍ចាប់ស្នូល កាមេរ៉ាវិទ្យាសាស្ត្រដើរតួនាទីយ៉ាងសំខាន់—គុណភាពបង្ហាញ ភាពប្រែប្រួល ល្បឿន និងភាពជឿជាក់របស់វាប៉ះពាល់ដោយផ្ទាល់ដល់ការរកឃើញពិការភាពនៅកម្រិតមីក្រូ និងណាណូ ក៏ដូចជាស្ថេរភាពនៃប្រព័ន្ធត្រួតពិនិត្យ។ ដើម្បីដោះស្រាយតម្រូវការកម្មវិធីចម្រុះ យើងផ្តល់ជូននូវផលប័ត្រកាមេរ៉ាដ៏ទូលំទូលាយ ចាប់ពីការស្កេនល្បឿនលឿនទ្រង់ទ្រាយធំរហូតដល់ដំណោះស្រាយ TDI កម្រិតខ្ពស់ ដែលត្រូវបានដាក់ពង្រាយយ៉ាងទូលំទូលាយនៅក្នុងការត្រួតពិនិត្យពិការភាព wafer ការធ្វើតេស្ត photoluminescence ការវាស់វែង wafer និងការត្រួតពិនិត្យគុណភាពវេចខ្ចប់។
-

Gemini 8KTDI កាមេរ៉ាក្រោយបំភ្លឺ TDI-sCMOS
ជួរ Spectral: 180-1100 nm
QE ធម្មតា៖ 63.9% @ 266 nm
អតិបរមា។ អត្រាបន្ទាត់៖ 1 MHz @ 8/10 ប៊ីត
ដំណាក់កាល TDI: 256
ចំណុចប្រទាក់ទិន្នន័យ៖ 100G / 40G CoF
វិធីសាស្រ្តត្រជាក់: ខ្យល់ / រាវមើលច្រើនទៀត -

Dhyana 9KTDI Pro កាមេរ៉ាក្រោយបំភ្លឺ TDI-sCMOS
ជួរ Spectral: 180-1100 nm
QE ធម្មតា៖ 50% @ 266 nm
អតិបរមា។ អត្រាបន្ទាត់៖ 600 kHz @ 8/10 ប៊ីត
ដំណាក់កាល TDI: 256
ចំណុចប្រទាក់ទិន្នន័យ៖ QSFP+
វិធីសាស្រ្តត្រជាក់: ខ្យល់ / រាវមើលច្រើនទៀត -

ឌីយ៉ាណា 9KTDI កាមេរ៉ាក្រោយបំភ្លឺ TDI-sCMOS
ជួរ Spectral: 180-1100 nm
QE ធម្មតា: 38% @ 266 nm
អតិបរមា។ អត្រាបន្ទាត់៖ 510 kHz @ 8 ប៊ីត
ដំណាក់កាល TDI: 256
ចំណុចប្រទាក់ទិន្នន័យ៖ CoaXPress 2.0
វិធីសាស្រ្តត្រជាក់: ខ្យល់ / រាវមើលច្រើនទៀត
-
តើ EMCCD អាចត្រូវជំនួសបានទេ ហើយតើយើងធ្លាប់ចង់បានវាដែរឬទេ?
 ៥២៣៤
៥២៣៤  2024-05-22
2024-05-22 -
ការប្រកួតប្រជែងក្នុងការស្កេនតំបន់? របៀបដែល TDI អាចចាប់យករូបភាពរបស់អ្នកបាន 10 ដង
 ៥៤០៧
៥៤០៧  2023-10-10
2023-10-10 -
ការបង្កើនល្បឿននៃការទទួលបានកម្រិតពន្លឺជាមួយ Line Scan TDI Imaging
 ៦៨១៥
៦៨១៥  2022-07-13
2022-07-13
-
ការតាមដានពន្លឺភ្លើងនៅក្នុងទឹកដែលមានភាពច្របូកច្របល់ខ្លាំង និងការអនុវត្តចំពោះការចតនៅក្រោមទឹក។
 ១០០០
១០០០  2022-08-31
2022-08-31 -
ការលូតលាស់នៃសរសៃប្រសាទនៃសរសៃប្រសាទ trigeminal ganglion នៅក្នុង vitro ជាមួយនឹងការ irradiation ពន្លឺជិតអ៊ីនហ្វ្រារ៉េដ
 ១០០០
១០០០  2022-08-24
2022-08-24 -
ផ្សិត និង Oomycetes ដែលធន់ទ្រាំនឹងសីតុណ្ហភាពខ្ពស់នៅក្នុងប្រទេសកូរ៉េ រួមទាំង Saksenaea longicolla sp. វិច្ឆិកា
 ១០០០
១០០០  2022-08-19
2022-08-19

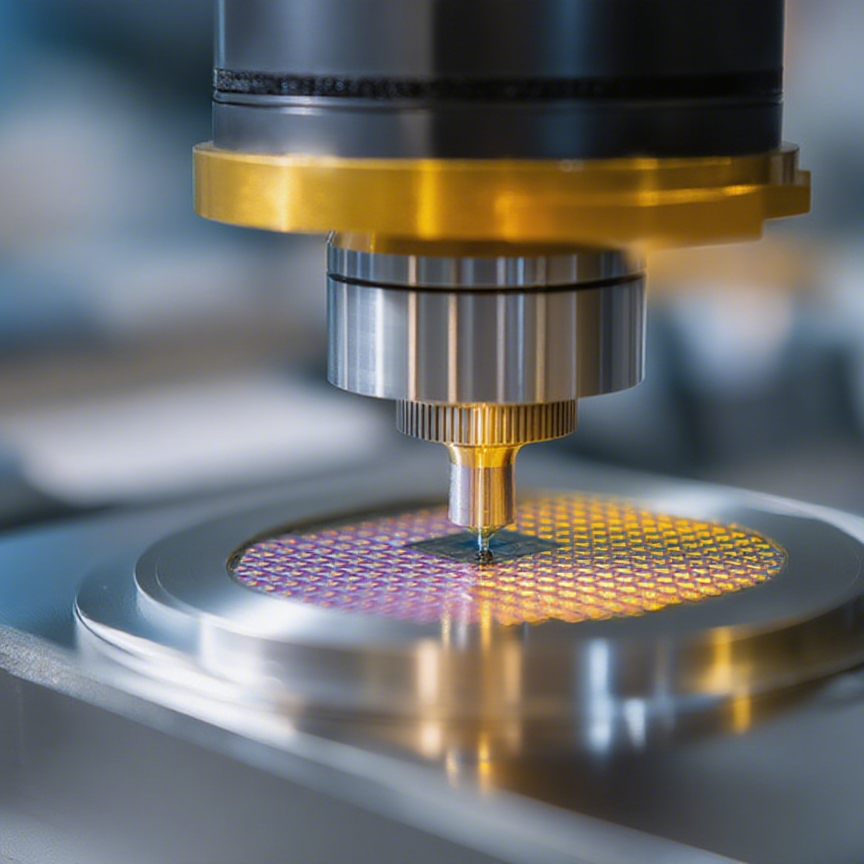

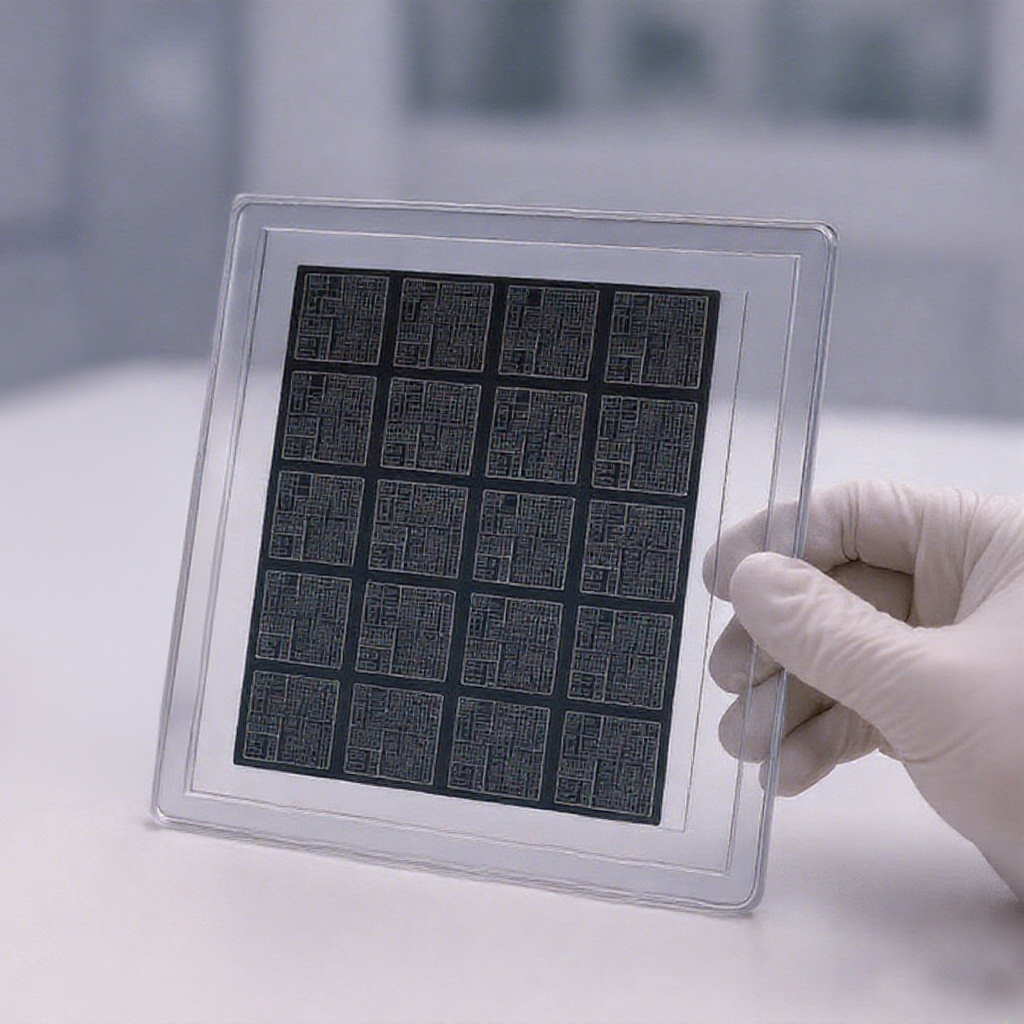

 ៥២៣៤
៥២៣៤